Halvlederlaserløfteutstyr revolusjonerer tynning av barrer
Detaljert diagram
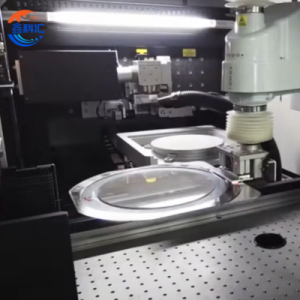
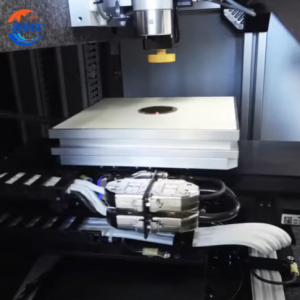
Produktinnføring av halvlederlaserløfteutstyr
Semiconductor Laser Lift-Off Equipment er en høyspesialisert industriell løsning konstruert for presis og kontaktløs tynning av halvlederbarrer gjennom laserinduserte lift-off-teknikker. Dette avanserte systemet spiller en sentral rolle i moderne halvlederwaferprosesser, spesielt i fabrikasjonen av ultratynne wafere for høyytelses kraftelektronikk, LED-er og RF-enheter. Ved å muliggjøre separasjon av tynne lag fra bulkbarrer eller donorsubstrater, revolusjonerer Semiconductor Laser Lift-Off Equipment tynning av barrer ved å eliminere mekanisk saging, sliping og kjemisk etsing.
Tradisjonell tynning av halvlederbarrer, som galliumnitrid (GaN), silisiumkarbid (SiC) og safir, er ofte arbeidskrevende, sløsende og utsatt for mikrosprekker eller overflateskader. I motsetning til dette tilbyr Semiconductor Laser Lift-Off Equipment et ikke-destruktivt, presist alternativ som minimerer materialtap og overflatestress samtidig som det øker produktiviteten. Det støtter et bredt utvalg av krystallinske og sammensatte materialer og kan sømløst integreres i front-end eller midstream halvlederproduksjonslinjer.
Med konfigurerbare laserbølgelengder, adaptive fokussystemer og vakuumkompatible waferchucker er dette utstyret spesielt godt egnet for blokkskjæring, lamellproduksjon og ultratynn filmavløsning for vertikale enhetsstrukturer eller heteroepitaksial lagoverføring.

Parameter for halvlederlaserløfteutstyr
| Bølgelengde | IR/SHG/THG/FHG |
|---|---|
| Pulsbredde | Nanosekund, pikosekund, femtosekund |
| Optisk system | Fast optisk system eller galvano-optisk system |
| XY-scenen | 500 mm × 500 mm |
| Behandlingsområde | 160 mm |
| Bevegelseshastighet | Maks 1000 mm/sek |
| Repeterbarhet | ±1 μm eller mindre |
| Absolutt posisjonsnøyaktighet: | ±5 μm eller mindre |
| Waferstørrelse | 2–6 tommer eller tilpasset |
| Kontroll | Windows 10, 11 og PLS |
| Strømforsyningsspenning | AC 200 V ±20 V, Enfase, 50/60 kHz |
| Eksterne dimensjoner | 2400 mm (B) × 1700 mm (D) × 2000 mm (H) |
| Vekt | 1000 kg |
Arbeidsprinsipp for halvlederlaserløfteutstyr
Kjernemekanismen til halvlederlaserløfteutstyr er avhengig av selektiv fototermisk dekomponering eller ablasjon ved grensesnittet mellom donorbarren og det epitaksiale eller mållaget. En høyenergi-UV-laser (vanligvis KrF ved 248 nm eller faststoff-UV-lasere rundt 355 nm) fokuseres gjennom et transparent eller semi-transparent donormateriale, hvor energien absorberes selektivt på en forhåndsbestemt dybde.
Denne lokaliserte energiabsorpsjonen skaper et høytrykkslag i gassfasen eller et termisk ekspansjonslag ved grensesnittet, som starter den rene delamineringen av det øvre wafer- eller enhetslaget fra barrens base. Prosessen finjusteres ved å justere parametere som pulsbredde, laserfluens, skannehastighet og z-aksens fokusdybde. Resultatet er en ultratynn skive – ofte i området 10 til 50 µm – som er rent separert fra den opprinnelige barren uten mekanisk slitasje.
Denne metoden for laserløfting for tynning av barrer unngår tap av snitt og overflateskader forbundet med diamantsaging eller mekanisk sliping. Den bevarer også krystallintegriteten og reduserer kravene til polering nedstrøms, noe som gjør Semiconductor Laser Lift-Off Equipment til et banebrytende verktøy for neste generasjons waferproduksjon.
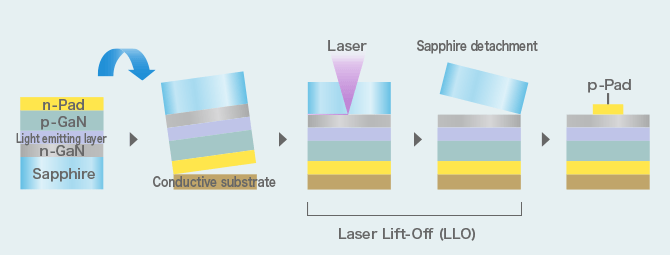
Anvendelser av halvlederlaserløfteutstyr
Halvlederlaserløfteutstyr finner bred anvendelse i tynning av barrer på tvers av en rekke avanserte materialer og enhetstyper, inkludert:
-
GaN- og GaAs-barretynning for kraftenheter
Muliggjør produksjon av tynne wafere for høyeffektive effekttransistorer og dioder med lav motstand.
-
Gjenvinning av SiC-substrat og lamellseparasjon
Tillater løfting i waferskala fra bulk SiC-substrater for vertikale enhetsstrukturer og gjenbruk av wafere.
-
LED-skiveroppskjæring
Gjør det lettere å løfte GaN-lag fra tykke safirbarrer for å produsere ultratynne LED-substrater.
-
Fabrikasjon av RF- og mikrobølgeenheter
Støtter ultratynne HEMT-strukturer (high-electron-mobility transistor) som trengs i 5G- og radarsystemer.
-
Epitaksial lagoverføring
Løsner presist epitaksiale lag fra krystallinske barrer for gjenbruk eller integrering i heterostrukturer.
-
Tynnfilmsolceller og fotovoltaikk
Brukes til å separere tynne absorberlag for fleksible eller høyeffektive solceller.
I hvert av disse domenene gir halvlederlaserløfteutstyr uovertruffen kontroll over tykkelsesjevnhet, overflatekvalitet og lagintegritet.
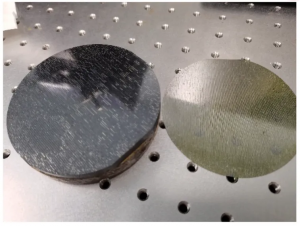
Fordeler med laserbasert ingotfortynning
-
Null snittmaterialetap
Sammenlignet med tradisjonelle waferskjæringsmetoder, resulterer laserprosessen i nesten 100 % materialutnyttelse.
-
Minimal stress og vridning
Kontaktløs løfting eliminerer mekanisk vibrasjon, noe som reduserer waferbøyning og dannelse av mikrosprekker.
-
Bevaring av overflatekvalitet
I mange tilfeller er det ikke nødvendig med etterpolering eller tynning, ettersom laserløfting bevarer overflatens integritet.
-
Høy gjennomstrømning og klar for automatisering
Kan behandle hundrevis av underlag per skift med automatisk lasting/lossing.
-
Tilpasningsdyktig til flere materialer
Kompatibel med GaN, SiC, safir, GaAs og nye III-V-materialer.
-
Miljømessig tryggere
Reduserer bruken av slipemidler og sterke kjemikalier som er typiske i slambaserte tynningsprosesser.
-
Gjenbruk av substrat
Donorbarrer kan resirkuleres for flere løftesykluser, noe som reduserer materialkostnadene betraktelig.
Ofte stilte spørsmål (FAQ) om halvlederlaserløfteutstyr
-
Q1: Hvilket tykkelsesområde kan Semiconductor Laser Lift-Off Equipment oppnå for waferskiver?
A1:Typisk skivetykkelse varierer fra 10 µm til 100 µm, avhengig av materiale og konfigurasjon.Q2: Kan dette utstyret brukes til å tynne ut barrer laget av ugjennomsiktige materialer som SiC?
A2:Ja. Ved å justere laserbølgelengden og optimalisere grensesnittteknikken (f.eks. offermellomlag), kan selv delvis ugjennomsiktige materialer bearbeides.Q3: Hvordan justeres donorsubstratet før laserløfting?
A3:Systemet bruker submikronbaserte synsbaserte justeringsmoduler med tilbakemelding fra referencemerker og overflaterefleksjonsskanninger.Q4: Hva er forventet syklustid for én laserløftingsoperasjon?
A4:Avhengig av waferstørrelse og tykkelse varer typiske sykluser fra 2 til 10 minutter.Q5: Krever prosessen et renromsmiljø?
A5:Selv om det ikke er obligatorisk, anbefales integrering i renrom for å opprettholde substratets renhet og enhetsutbytte under høypresisjonsoperasjoner.
Om oss
XKH spesialiserer seg på høyteknologisk utvikling, produksjon og salg av spesialoptisk glass og nye krystallmaterialer. Produktene våre brukes til optisk elektronikk, forbrukerelektronikk og militæret. Vi tilbyr optiske safirkomponenter, mobiltelefonlinsedeksler, keramikk, LT, silisiumkarbid SIC, kvarts og halvlederkrystallwafere. Med dyktig ekspertise og banebrytende utstyr utmerker vi oss innen ikke-standard produktbehandling, med mål om å være en ledende høyteknologisk bedrift innen optoelektroniske materialer.










