Selv om både silisium- og glassskiver har det felles målet om å bli «renset», er utfordringene og feilmodusene de møter under rengjøring svært forskjellige. Denne avviken oppstår fra de iboende materialegenskapene og spesifikasjonskravene til silisium og glass, samt den distinkte «filosofien» bak rengjøring som er drevet av deres endelige bruksområder.
La oss først avklare: Hva rengjør vi egentlig? Hvilke forurensninger er involvert?
Forurensninger kan klassifiseres i fire kategorier:
-
Partikkelforurensninger
-
Støv, metallpartikler, organiske partikler, slipende partikler (fra CMP-prosessen), osv.
-
Disse forurensningene kan forårsake mønsterfeil, som kortslutninger eller åpne kretser.
-
-
Organiske forurensninger
-
Inkluderer fotoresistrester, harpikstilsetningsstoffer, hudoljer fra mennesker, løsemiddelrester osv.
-
Organiske forurensninger kan danne masker som hindrer etsing eller ionimplantasjon og reduserer adhesjon av andre tynne filmer.
-
-
Metallionforurensninger
-
Jern, kobber, natrium, kalium, kalsium osv., som hovedsakelig kommer fra utstyr, kjemikalier og menneskelig kontakt.
-
I halvledere er metallioner «drepende» forurensninger, som introduserer energinivåer i det forbudte båndet, noe som øker lekkasjestrømmen, forkorter bærerens levetid og skader de elektriske egenskapene alvorlig. I glass kan de påvirke kvaliteten og adhesjonen til påfølgende tynne filmer.
-
-
Naturlig oksidlag
-
For silisiumskiver: Et tynt lag med silisiumdioksid (naturlig oksid) dannes naturlig på overflaten i luften. Tykkelsen og ensartetheten til dette oksidlaget er vanskelig å kontrollere, og det må fjernes fullstendig under fabrikasjonen av nøkkelstrukturer som gateoksider.
-
For glassskiver: Glass i seg selv er en nettverksstruktur av silika, så det er ikke noe problem med å «fjerne et naturlig oksidlag». Overflaten kan imidlertid ha blitt modifisert på grunn av forurensning, og dette laget må fjernes.
-

I. Kjernemål: Forskjellen mellom elektrisk ytelse og fysisk perfeksjon
-
Silisiumskiver
-
Kjernemålet med rengjøring er å sikre elektrisk ytelse. Spesifikasjoner inkluderer vanligvis strenge partikkeltall og -størrelser (f.eks. må partikler ≥0,1 μm fjernes effektivt), metallionkonsentrasjoner (f.eks. Fe, Cu må kontrolleres til ≤10¹⁰ atomer/cm² eller lavere), og nivåer av organiske rester. Selv mikroskopisk forurensning kan føre til kortslutninger, lekkasjestrømmer eller svikt i gate-oksidintegriteten.
-
-
Glassvafler
-
Som underlag er kjernekravene fysisk perfeksjon og kjemisk stabilitet. Spesifikasjonene fokuserer på makronivåaspekter som fravær av riper, ikke-fjernbare flekker og opprettholdelse av den opprinnelige overflateruheten og geometrien. Rengjøringsmålet er primært å sikre visuell renhet og god vedheft for påfølgende prosesser som belegg.
-
II. Materiell natur: Den grunnleggende forskjellen mellom krystallinsk og amorf
-
Silisium
-
Silisium er et krystallinsk materiale, og overflaten danner naturlig et ujevnt silisiumdioksid (SiO₂) oksidlag. Dette oksidlaget utgjør en risiko for elektrisk ytelse og må fjernes grundig og jevnt.
-
-
Glass
-
Glass er et amorft silikanettverk. Bulkmaterialet har en lignende sammensetning som silisiumoksidlaget i silisium, noe som betyr at det raskt kan etses med flussyre (HF) og er også utsatt for sterk alkalierosjon, noe som fører til økt overflateruhet eller deformasjon. Denne grunnleggende forskjellen dikterer at rengjøring av silisiumskiver tåler lett, kontrollert etsing for å fjerne forurensninger, mens rengjøring av glassskiver må utføres med ekstrem forsiktighet for å unngå å skade basismaterialet.
-
| Rengjøringsartikkel | Rengjøring av silikonskiver | Rengjøring av glassplater |
|---|---|---|
| Rengjøringsmål | Inkluderer sitt eget naturlige oksidlag | Velg rengjøringsmetode: Fjern forurensninger samtidig som du beskytter grunnmaterialet |
| Standard RCA-rengjøring | - SPM(H₂SO₄/H₂O₂): Fjerner organiske/fotoresistrester | Hovedrengjøringsflyt: |
| - SC1(NH₄OH/H₂O₂/H₂O): Fjerner overflatepartikler | Svak alkalisk rengjøringsmiddelInneholder aktive overflateaktive stoffer for å fjerne organiske forurensninger og partikler | |
| - DHF(Fluorsyre): Fjerner naturlig oksidlag og andre forurensninger | Sterkt alkalisk eller mellomalkalisk rengjøringsmiddelBrukes til å fjerne metalliske eller ikke-flyktige forurensninger | |
| - SC2(HCl/H₂O₂/H₂O): Fjerner metallforurensninger | Unngå HF gjennomgående | |
| Viktige kjemikalier | Sterke syrer, sterke baser, oksiderende løsemidler | Svak alkalisk rengjøringsmiddel, spesielt formulert for fjerning av mild forurensning |
| Fysiske hjelpemidler | Avionisert vann (for skylling med høy renhet) | Ultralyd, megasonisk vasking |
| Tørketeknologi | Megasonic, IPA damptørking | Skånsom tørking: Sakte løft, IPA-damptørking |
III. Sammenligning av rengjøringsløsninger
Basert på de ovennevnte målene og materialegenskapene, er rengjøringsløsningene for silisium- og glassskiver forskjellige:
| Rengjøring av silikonskiver | Rengjøring av glassplater | |
|---|---|---|
| Rengjøringsmål | Grundig fjerning, inkludert waferens naturlige oksidlag. | Selektiv fjerning: Fjerner forurensninger samtidig som underlaget beskyttes. |
| Typisk prosess | Standard RCA-rens:•SPM(H₂SO₄/H₂O₂): fjerner tunge organiske stoffer/fotoresist •SC1(NH₄OH/H₂O₂/H₂O): fjerning av alkaliske partikler •DHF(fortynnet HF): fjerner naturlig oksidlag og metaller •SC2(HCl/H₂O₂/H₂O): fjerner metallioner | Karakteristisk rengjøringsflyt:•Mildt alkalisk rengjøringsmiddelmed overflateaktive stoffer for å fjerne organiske stoffer og partikler •Surt eller nøytralt rengjøringsmiddelfor fjerning av metallioner og andre spesifikke forurensninger •Unngå HF gjennom hele prosessen |
| Viktige kjemikalier | Sterke syrer, sterke oksidasjonsmidler, alkaliske løsninger | Mildt alkaliske rengjøringsmidler; spesialiserte nøytrale eller svakt sure rengjøringsmidler |
| Fysisk assistanse | Megasonic (høy effektivitet, skånsom partikkelfjerning) | Ultralyd, megasonisk |
| Tørking | Marangoni tørking; IPA damptørking | Langsom tørking; IPA-damptørking |
-
Rengjøringsprosess for glassplater
-
For tiden bruker de fleste glassforedlingsanlegg rengjøringsprosedyrer basert på glassets materialegenskaper, og er hovedsakelig avhengige av svake alkaliske rengjøringsmidler.
-
Rengjøringsmiddelets egenskaper:Disse spesialiserte rengjøringsmidlene er vanligvis svakt alkaliske, med en pH-verdi på rundt 8–9. De inneholder vanligvis overflateaktive stoffer (f.eks. alkylpolyoksyetyleter), metallkelateringsmidler (f.eks. HEDP) og organiske rengjøringsmidler, utviklet for å emulgere og dekomponere organiske forurensninger som oljer og fingeravtrykk, samtidig som de er minimalt korrosive for glassmatrisen.
-
Prosessflyt:Den typiske rengjøringsprosessen innebærer bruk av en spesifikk konsentrasjon av svake alkaliske rengjøringsmidler ved temperaturer fra romtemperatur til 60 °C, kombinert med ultralydrengjøring. Etter rengjøring gjennomgår waferne flere skyllingstrinn med rent vann og forsiktig tørking (f.eks. langsom løfting eller IPA-damptørking). Denne prosessen oppfyller effektivt kravene til glasswafere for visuell renslighet og generell renslighet.
-
-
Rengjøringsprosess for silikonskiver
-
For halvlederbehandling gjennomgår silisiumskiver vanligvis standard RCA-rengjøring, som er en svært effektiv rengjøringsmetode som systematisk kan adressere alle typer forurensninger, og sikrer at de elektriske ytelseskravene for halvlederenheter oppfylles.
-
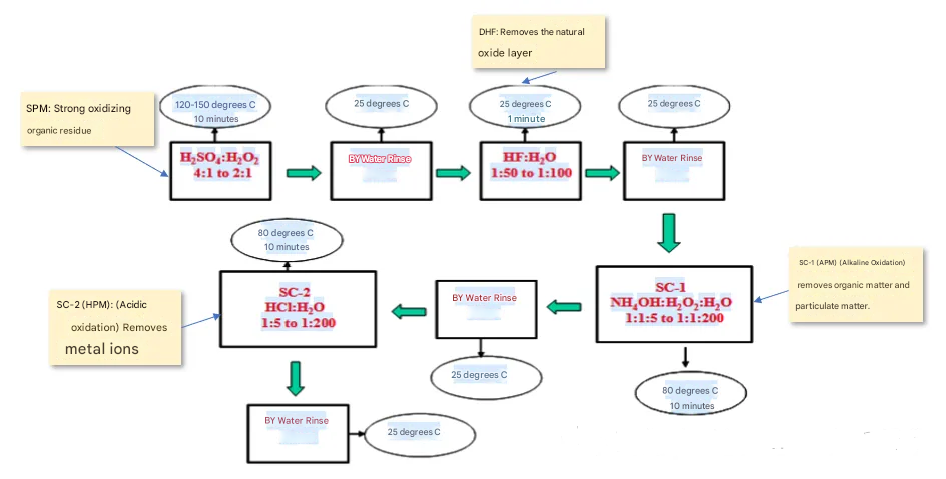
IV. Når glass oppfyller høyere standarder for «renslighet»
Når glassskiver brukes i applikasjoner som krever strenge partikkeltall og metallionnivåer (f.eks. som substrater i halvlederprosesser eller for utmerkede tynnfilmavsetningsoverflater), er det ikke sikkert at den iboende rengjøringsprosessen lenger er tilstrekkelig. I dette tilfellet kan prinsipper for halvlederrengjøring anvendes, og en modifisert RCA-rengjøringsstrategi introduseres.
Kjernen i denne strategien er å fortynne og optimalisere standard RCA-prosessparametrene for å imøtekomme glassets følsomme natur:
-
Fjerning av organisk forurensning:SPM-løsninger eller mildere ozonvann kan brukes til å dekomponere organiske forurensninger gjennom sterk oksidasjon.
-
Fjerning av partikler:Høyt fortynnet SC1-løsning brukes ved lavere temperaturer og kortere behandlingstider for å utnytte dens elektrostatiske frastøtnings- og mikroetsingseffekter for å fjerne partikler, samtidig som korrosjon på glasset minimeres.
-
Fjerning av metallioner:En fortynnet SC2-løsning eller enkle fortynnede saltsyre-/fortynnede salpetersyreløsninger brukes til å fjerne metallforurensninger via chelatering.
-
Strenge forbud:DHF (diammoniumfluorid) må absolutt unngås for å forhindre korrosjon av glasssubstratet.
I hele den modifiserte prosessen forbedrer kombinasjonen av megasonisk teknologi fjerningseffektiviteten av nanopartikler betydelig og er mer skånsom mot overflaten.
Konklusjon
Rengjøringsprosessene for silisium- og glassskiver er det uunngåelige resultatet av reverse engineering basert på deres endelige brukskrav, materialegenskaper og fysiske og kjemiske egenskaper. Rengjøring av silisiumskiver søker "atomnivårenslighet" for elektrisk ytelse, mens rengjøring av glassskiver fokuserer på å oppnå "perfekte, uskadede" fysiske overflater. Etter hvert som glassskiver i økende grad brukes i halvlederapplikasjoner, vil rengjøringsprosessene deres uunngåelig utvikle seg utover tradisjonell svak alkalisk rengjøring, og utvikle mer raffinerte, tilpassede løsninger som den modifiserte RCA-prosessen for å møte høyere renhetsstandarder.
Publisert: 29. oktober 2025
