Introduksjon til silisiumkarbid
Silisiumkarbid (SiC) er et sammensatt halvledermateriale bestående av karbon og silisium, som er et av de ideelle materialene for å lage høytemperatur-, høyfrekvente-, høyeffekt- og høyspenningsenheter. Sammenlignet med tradisjonelt silisiummateriale (Si) er båndgapet til silisiumkarbid tre ganger så høyt som silisium. Varmeledningsevnen er 4–5 ganger så høy som silisium; gjennomslagsspenningen er 8–10 ganger så høy som silisium; den elektroniske metningsdriftshastigheten er 2–3 ganger så høy som silisium, noe som dekker behovene til moderne industri for høy effekt, høy spenning og høy frekvens. Det brukes hovedsakelig til produksjon av høyhastighets-, høyfrekvente-, høyeffekt- og lysutstrålende elektroniske komponenter. Nedstrøms bruksområder inkluderer smartnett, nye energikjøretøyer, solcelledrevet vindkraft, 5G-kommunikasjon, etc. Silisiumkarbiddioder og MOSFET-er har blitt kommersielt brukt.

Høy temperaturmotstand. Båndgapbredden til silisiumkarbid er 2–3 ganger større enn for silisium, elektronene er ikke lette å overføre ved høye temperaturer, og de tåler høyere driftstemperaturer, og termisk ledningsevne til silisiumkarbid er 4–5 ganger større enn for silisium, noe som gjør enhetens varmespredning enklere og grensen for driftstemperatur høyere. Høy temperaturmotstand kan øke effekttettheten betydelig, samtidig som kravene til kjølesystemet reduseres, noe som gjør terminalen lettere og mindre.
Tåler høyt trykk. Silisiumkarbids elektriske feltstyrke er 10 ganger høyere enn silisium, som tåler høyere spenninger og er mer egnet for høyspenningsenheter.
Høyfrekvent motstand. Silisiumkarbid har en mettet elektrondriftshastighet som er dobbelt så høy som silisium, noe som resulterer i fravær av strømavvik under avstengningsprosessen, noe som effektivt kan forbedre enhetens svitsjefrekvens og realisere miniatyriseringen av enheten.
Lavt energitap. Sammenlignet med silisiummateriale har silisiumkarbid svært lav innkoblingsmotstand og lavt innkoblingstap. Samtidig reduserer silisiumkarbidets høye båndgapbredde lekkasjestrømmen og effekttapet betraktelig. I tillegg har ikke silisiumkarbidenheten strømslepefenomen under avstengningsprosessen, og koblingstapet er lavt.
Silisiumkarbidindustrikjede
Det omfatter hovedsakelig substrat, epitaksi, enhetsdesign, produksjon, forsegling og så videre. Silisiumkarbid fra materialet til halvlederkraftenheten vil gjennomgå enkeltkrystallvekst, ingotskjæring, epitaksialvekst, waferdesign, produksjon, emballasje og andre prosesser. Etter syntesen av silisiumkarbidpulver lages først silisiumkarbidbarren, og deretter oppnås silisiumkarbidsubstratet ved skjæring, sliping og polering, og epitaksialplaten oppnås ved epitaksialvekst. Den epitaksiale waferen er laget av silisiumkarbid gjennom litografi, etsning, ionimplantasjon, metallpassivering og andre prosesser, waferen kuttes til form, enheten pakkes, og enheten kombineres til et spesielt skall og settes sammen til en modul.
Oppstrøms i industrikjeden 1: substrat - krystallvekst er kjerneprosessens ledd
Silisiumkarbidsubstrat står for omtrent 47 % av kostnaden for silisiumkarbidenheter, den høyeste produksjonstekniske barrieren, den største verdien, og er kjernen i den fremtidige storskala industrialiseringen av SiC.
Fra et perspektiv på forskjeller i elektrokjemiske egenskaper kan silisiumkarbidsubstratmaterialer deles inn i ledende substrater (resistivitetsområde 15~30 mΩ·cm) og halvisolerte substrater (resistivitet høyere enn 105 Ω·cm). Disse to typene substrater brukes til å produsere separate enheter som henholdsvis kraftenheter og radiofrekvensenheter etter epitaksial vekst. Blant disse brukes halvisolert silisiumkarbidsubstrat hovedsakelig i produksjonen av galliumnitrid RF-enheter, fotoelektriske enheter og så videre. Ved å dyrke et gan epitaksialt lag på et halvisolert SIC-substrat, fremstilles en sic epitaksialplate, som videre kan fremstilles til HEMT gan iso-nitrid RF-enheter. Ledende silisiumkarbidsubstrat brukes hovedsakelig i produksjonen av kraftenheter. I motsetning til den tradisjonelle produksjonsprosessen for silisiumkraftenheter, kan ikke silisiumkarbidkraftenheten lages direkte på silisiumkarbidsubstratet. Det epitaksiale laget av silisiumkarbid må dyrkes på det ledende substratet for å få det epitaksiale arket av silisiumkarbid, og det epitaksiale laget produseres på Schottky-dioder, MOSFET, IGBT og andre kraftenheter.
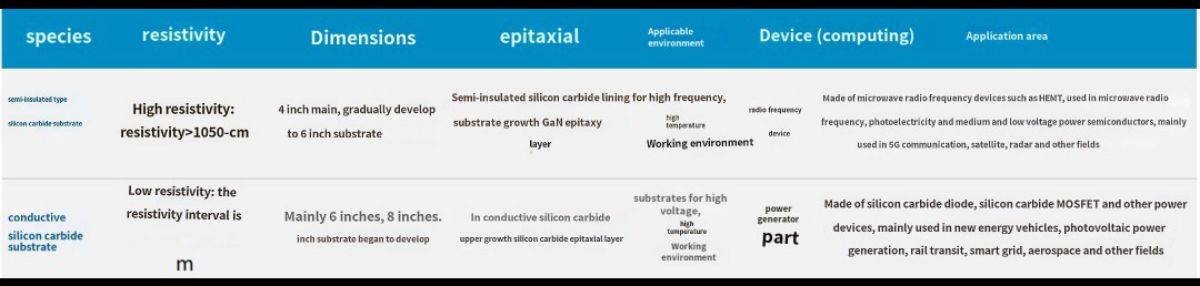
Silisiumkarbidpulver ble syntetisert fra karbonpulver med høy renhet og silisiumpulver med høy renhet, og silisiumkarbidbarrer i forskjellige størrelser ble dyrket under et spesielt temperaturfelt, og deretter ble silisiumkarbidsubstrat produsert gjennom flere prosesseringsprosesser. Kjerneprosessen inkluderer:
Råmaterialesyntese: Silisiumpulver med høy renhet + toner blandes i henhold til formelen, og reaksjonen utføres i reaksjonskammeret under høy temperatur over 2000 °C for å syntetisere silisiumkarbidpartiklene med spesifikk krystalltype og partikkelstørrelse. Deretter gjennomgår de knusing, sikting, rengjøring og andre prosesser for å oppfylle kravene til råmaterialer for silisiumkarbidpulver med høy renhet.
Krystallvekst er kjerneprosessen i produksjon av silisiumkarbidsubstrat, som bestemmer de elektriske egenskapene til silisiumkarbidsubstratet. For tiden er de viktigste metodene for krystallvekst fysisk dampoverføring (PVT), høytemperaturkjemisk dampavsetning (HT-CVD) og væskefaseepitaksi (LPE). Blant disse er PVT-metoden den vanligste metoden for kommersiell vekst av SiC-substrat for tiden, med den høyeste tekniske modenheten og den mest brukte innen ingeniørfag.

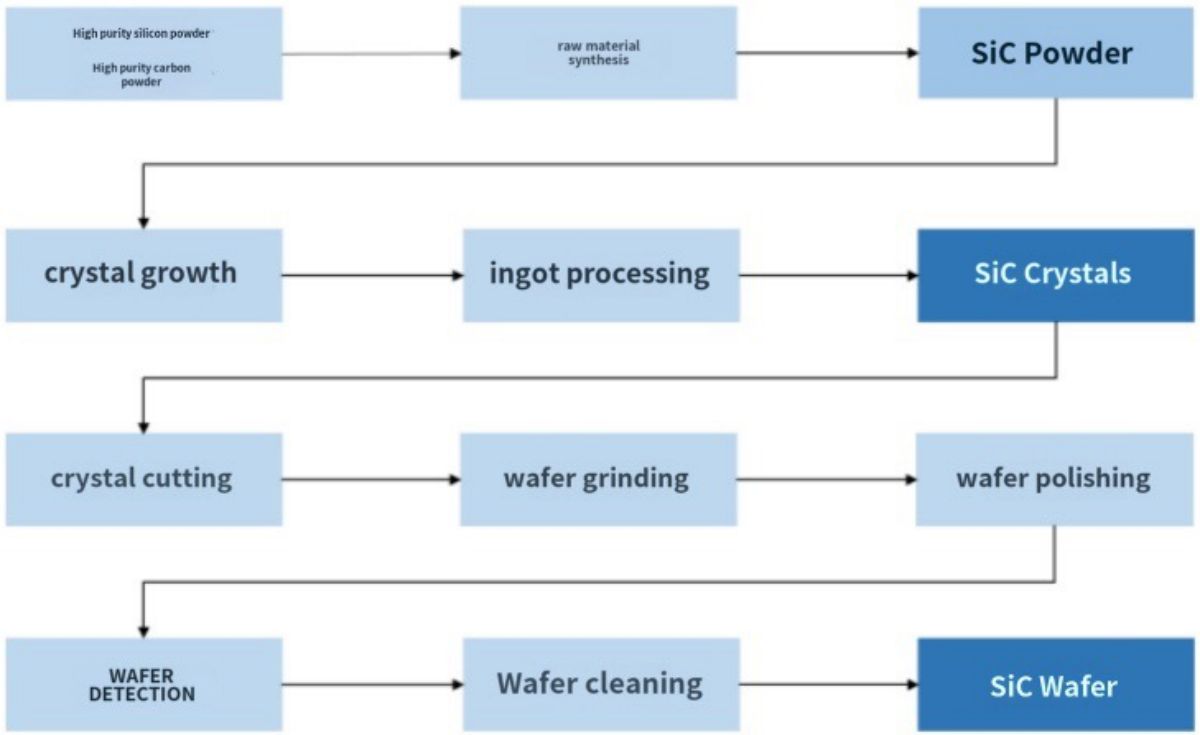
Fremstilling av SiC-substrat er vanskelig, noe som fører til den høye prisen.
Temperaturfeltkontroll er vanskelig: Vekst av Si-krystallstaver trenger bare 1500 ℃, mens SiC-krystallstaver må dyrkes ved en høy temperatur over 2000 ℃, og det finnes mer enn 250 SiC-isomerer, men den viktigste 4H-SiC-enkrystallstrukturen for produksjon av kraftenheter, hvis ikke presis kontroll, vil få andre krystallstrukturer. I tillegg bestemmer temperaturgradienten i digelen hastigheten på SiC-sublimeringsoverføring og arrangementet og vekstmodusen til gassatomer på krystallgrensesnittet, noe som påvirker krystallveksthastigheten og krystallkvaliteten, så det er nødvendig å danne en systematisk temperaturfeltkontrollteknologi. Sammenlignet med Si-materialer er forskjellen i SiC-produksjon også i høytemperaturprosesser som høytemperaturionimplantasjon, høytemperaturoksidasjon, høytemperaturaktivering og hardmaskeprosessen som kreves av disse høytemperaturprosessene.
Langsom krystallvekst: Veksthastigheten til Si-krystallstenger kan nå 30 ~ 150 mm/t, og produksjonen av 1-3 m silisiumkrystallstenger tar bare omtrent 1 dag; for eksempel med PVT-metoden er veksthastigheten for SiC-krystallstenger omtrent 0,2-0,4 mm/t, veksten er mindre enn 3-6 cm på 7 dager, veksthastigheten er mindre enn 1 % av silisiummaterialet, og produksjonskapasiteten er ekstremt begrenset.
Høye produktparametere og lavt utbytte: Kjerneparametrene til SiC-substrat inkluderer mikrotubulitetetthet, dislokasjonstetthet, resistivitet, vridning, overflateruhet, etc. Det er et komplekst systemteknikk å arrangere atomer i et lukket høytemperaturkammer og fullføre krystallvekst, samtidig som parameterindeksene kontrolleres.
Materialet har høy hardhet, høy sprøhet, lang skjæretid og høy slitasje: SiC Mohs-hardhet på 9,25 er nest etter diamant, noe som fører til en betydelig økning i vanskelighetsgraden ved skjæring, sliping og polering, og det tar omtrent 120 timer å skjære 35–40 stykker av en 3 cm tykk barre. I tillegg, på grunn av SiCs høye sprøhet, vil slitasjen under waferbehandling være høyere, og produksjonsforholdet er bare omtrent 60 %.
Utviklingstrend: Størrelsesøkning + prisnedgang
Det globale SiC-markedet for 6-tommers volumproduksjonslinjer modnes, og ledende selskaper har gått inn i 8-tommersmarkedet. Innenlandske utviklingsprosjekter er hovedsakelig 6-tommers. Selv om de fleste innenlandske selskaper fortsatt er basert på 4-tommers produksjonslinjer, utvides industrien gradvis til 6-tommers. Med modningen av 6-tommers støtteutstyrsteknologi forbedres også innenlandsk SiC-substratteknologi gradvis. Stordriftsfordelene ved store produksjonslinjer vil gjenspeiles, og det nåværende tidsgapet for innenlandsk 6-tommers masseproduksjon har blitt redusert til 7 år. Større waferstørrelser kan føre til en økning i antall enkeltbrikker, forbedre utbyttet og redusere andelen kantbrikker, og kostnadene for forskning og utvikling og utbyttetap vil holdes på omtrent 7 %, og dermed forbedre waferutnyttelsen.
Det er fortsatt mange vanskeligheter med enhetsdesign
Kommersialiseringen av SiC-dioder forbedres gradvis. For tiden har en rekke innenlandske produsenter utviklet SiC SBD-produkter. SiC SBD-produkter for mellom- og høyspenning har god stabilitet. I kjøretøyets OBC oppnår man stabil strømtetthet ved bruk av SiC SBD + SI IGBT. For tiden er det ingen barrierer for patentdesign av SiC SBD-produkter i Kina, og gapet til utlandet er lite.
SiC MOS har fortsatt mange vanskeligheter, det er fortsatt et gap mellom SiC MOS og utenlandske produsenter, og den relevante produksjonsplattformen er fortsatt under bygging. For tiden har ST, Infineon, Rohm og andre 600-1700V SiC MOS oppnådd masseproduksjon og signert og levert med mange produksjonsindustrier, mens den nåværende innenlandske SiC MOS-designen i hovedsak er fullført, en rekke designprodusenter jobber med fabrikker i waferflytstadiet, og senere kundeverifisering tar fortsatt litt tid, så det er fortsatt lang tid før storskala kommersialisering.
For tiden er planstruktur det vanligste valget, og grøftetypen vil bli mye brukt i høytrykksfeltet i fremtiden. Det finnes mange produsenter av SiC MOS med planstruktur. Planstrukturen er ikke lett å produsere lokale havariproblemer sammenlignet med sporet, noe som påvirker arbeidsstabiliteten. I markedet under 1200 V har den et bredt spekter av bruksverdier, og den planstrukturen er relativt enkel i produksjonsenden for å oppfylle to aspekter knyttet til produksjonsbarhet og kostnadskontroll. Sporanordningen har fordelene med ekstremt lav parasittisk induktans, rask byttehastighet, lavt tap og relativt høy ytelse.
2 - Nyheter om SiC-wafere
Vekst i produksjon og salg av silisiumkarbid i markedet, vær oppmerksom på strukturell ubalanse mellom tilbud og etterspørsel


Med den raske veksten i markedets etterspørsel etter høyfrekvent og høyeffekts kraftelektronikk, har den fysiske grenseflaskehalsen til silisiumbaserte halvlederkomponenter gradvis blitt fremtredende, og tredjegenerasjons halvledermaterialer representert av silisiumkarbid (SiC) har gradvis blitt industrialisert. Fra et materialegenskapssynspunkt har silisiumkarbid 3 ganger båndgapbredden til silisiummaterialet, 10 ganger den kritiske gjennombrudds-elektriske feltstyrken, 3 ganger varmeledningsevnen, slik at silisiumkarbid-kraftkomponenter er egnet for høyfrekvente, høytrykks-, høytemperatur- og andre applikasjoner, og bidrar til å forbedre effektiviteten og effekttettheten til kraftelektroniske systemer.
For tiden har SiC-dioder og SiC MOSFET-er gradvis kommet på markedet, og det finnes mer modne produkter. Blant disse er SiC-dioder mye brukt i stedet for silisiumbaserte dioder på noen felt fordi de ikke har fordelen med revers gjenopprettingsladning. SiC MOSFET brukes også gradvis innen bilindustrien, energilagring, ladestabler, solceller og andre felt. Innen bilindustrien blir trenden med modularisering mer og mer fremtredende, og den overlegne ytelsen til SiC må stole på avanserte pakkeprosesser for å oppnå dette. Teknisk sett med relativt moden skallforsegling som hovedstrøm, er fremtiden for utvikling av plastforsegling, og dens tilpassede utviklingsegenskaper er mer egnet for SiC-moduler.
Prisfallet på silisiumkarbid er raskere enn forventet

Bruksområdet for silisiumkarbidenheter er hovedsakelig begrenset av høye kostnader. Prisen på SiC MOSFET er fire ganger høyere enn prisen på Si-baserte IGBT-er på samme nivå. Dette skyldes at silisiumkarbidprosessen er kompleks. Veksten av enkeltkrystaller og epitaksimaler er ikke bare hard mot miljøet, men veksthastigheten er også langsom. Enkeltkrystallprosessen til substratet må gjennomgå en skjære- og poleringsprosess. Basert på materialegenskapene og den umodne prosesseringsteknologien er utbyttet av husholdningssubstratet mindre enn 50 %, og ulike faktorer fører til høye priser på substrater og epitaksimaler.
Kostnadssammensetningen for silisiumkarbidenheter og silisiumbaserte enheter er imidlertid diametralt motsatt. Substrat- og epitaksialkostnadene for frontkanalen utgjør henholdsvis 47 % og 23 % av hele enheten, til sammen omtrent 70 %. Design, produksjon og tetningsledd for bakkanalen utgjør bare 30 %. Produksjonskostnadene for silisiumbaserte enheter er hovedsakelig konsentrert om waferproduksjon av bakkanalen på omtrent 50 %. Substratkostnadene utgjør bare 7 %. Fenomenet med verdien av silisiumkarbidindustrikjeden opp ned betyr at oppstrøms substratepitaksiprodusenter har kjerneretten til å snakke, noe som er nøkkelen til utformingen av innenlandske og utenlandske bedrifter.
Fra et dynamisk markedsperspektiv er det å redusere kostnadene for silisiumkarbid, i tillegg til å forbedre silisiumkarbidets lange krystaller og slicing-prosesser, å utvide waferstørrelsen, som også har vært den modne veien for halvlederutvikling tidligere. Wolfspeed-data viser at oppgradering av silisiumkarbidsubstrat fra 6 tommer til 8 tommer kan øke produksjonen av kvalifiserte brikketyper med 80% -90%, og bidra til å forbedre utbyttet. Kan redusere den samlede enhetskostnaden med 50%.
2023 er kjent som «8-tommers SiC-første år». I år akselererer innenlandske og utenlandske silisiumkarbidprodusenter utformingen av 8-tommers silisiumkarbid. Wolfspeeds vanvittige investering på 14,55 milliarder amerikanske dollar i utvidelse av silisiumkarbidproduksjonen er blant annet byggingen av et 8-tommers SiC-substratproduksjonsanlegg. For å sikre fremtidig forsyning av 200 mm SiC bart metall til en rekke selskaper, har de innenlandske Tianyue Advanced og Tianke Heda også signert langsiktige avtaler med Infineon om å levere 8-tommers silisiumkarbidsubstrater i fremtiden.
Fra og med i år vil silisiumkarbid øke fra 6 tommer til 8 tommer. Wolfspeed forventer at enhetsbrikkekostnaden for 8-tommers substrat vil bli redusert med mer enn 60 % innen 2024 sammenlignet med enhetsbrikkekostnaden for 6-tommers substrat i 2022, og kostnadsnedgangen vil åpne applikasjonsmarkedet ytterligere, påpeker forskningsdata fra Ji Bond Consulting. Den nåværende markedsandelen for 8-tommers produkter er mindre enn 2 %, og markedsandelen forventes å vokse til omtrent 15 % innen 2026.
Faktisk kan prisfallet på silisiumkarbidsubstrat overgå manges fantasi. Det nåværende markedstilbudet på 6-tommers substrat er 4000-5000 yuan/stykke, sammenlignet med begynnelsen av året har det falt mye, og det forventes at det vil falle under 4000 yuan neste år. Det er verdt å merke seg at noen produsenter har redusert salgsprisen til en lavere kostnadslinje for å komme seg inn på markedet. Dette har åpnet en priskrig som hovedsakelig er konsentrert om silisiumkarbidsubstrat, og tilbudet har vært relativt tilstrekkelig innen lavspenning. Innenlandske og utenlandske produsenter utvider produksjonskapasiteten aggressivt, eller lar overforsyningen av silisiumkarbidsubstrat komme tidligere enn forventet.
Publisert: 19. januar 2024
